电子封装用功能梯度铝基复合材料研究应用进展
方杰1,2,刘彦强3,杨志宇3,樊建中1,刁恩泽1,崔西会2,黎康杰2,彭颐豫2,张坤2,孔欣2,杨博2(1北京有色金属研究总院;2中国电子科技集团公司第二十九研究所;3有研金属复合材料(北京)股份有限公司)
摘要:电子信息系统小型化、轻量化、无人化、一体化的发展趋势要求电子封装持续减小尺寸、降低重量和减少功耗(SWaP,即Size,Weight and Power)。传统的基于可伐合金、铝合金和高硅铝的微电子封装材料难以同时满足大跨度热匹配、良好的钎焊与激光熔焊性能、高导热、高比刚度、高比强度和良好的可制造性,无法适应SWaP 要求。功能梯度铝基复合材料综合了铝合金与铝硅、碳化硅铝等先进复合材料的优点,既具备大跨度热匹配、高导热率的特点,又具备精细加工和良好的激光熔焊等工艺性能,是新一代微电子封装材料的研究热点。本文综述了功能梯度铝基复合材料的优势、制备方法和封装应用情况,并对该材料制备与应用中存在的问题进行了总结,最后对其未来研究方向进行了展望。
关键词:先进金属基复合材料;功能梯度材料;铝基复合材料;电子封装;研究应用进展
目录介绍
1 功能梯度铝基复合材料的封装优势
2 功能梯度铝基复合材料制备研究进展
2. 1 压力浸渗法
2. 2 激光熔覆法
2. 3 离心铸造法
2. 4 喷射沉积法
2. 5 粉末冶金法
3 电子封装用功能梯度铝基复合材料应用进展
3. 1 材料体系选择
3. 2 梯度复合结构与应用
3. 3 材料表征与分析
3. 4 小结
4 总结与展望
©软件著作权归作者所有。本站所有文件均来源于网络,仅供学习使用,请支持正版!
转载请注明出处!
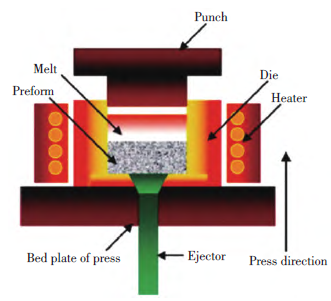







发表评论 取消回复