芯片高密度互连电子电镀成形与性能调控技术研究
吴蕴雯, 杭弢, 凌惠琴, 胡安民, 李明 (上海交通大学材料科学与工程学院电子材料与技术研究所)
摘要:信息技术的飞速发展, 对芯片性能提出了越来越高的要求, 芯片中晶体管和电子互连的密度也在不断增加。电子电镀是大马士革以及芯片封装电子互连的主要成形方法, 互连密度的提高对于电子电镀成形工艺及性能调控方法提出了许多新的要求。本文概述了本团队近几年在芯片高密度互连的电子电镀成形方法以及性能调控方面的研究成果, 主要包括3D TSV垂直互连及大马士革互连的填充及后处理工艺、高密度凸点电镀成形方法及互连界面可靠性研究、特殊结构微纳互连的制备及性能调控方法、微纳针锥结构低温固态键合方法、水相化学及电化学接枝有机绝缘膜等工作, 以期对芯片电子电镀领域的研究带来启迪, 推动芯片高密度互连技术的发展。
关键词:高密度互连, 电子电镀, 成形方法, 性能调控
目录介绍
1 引言
2 3D及微纳互连材料与电镀成形技术
2.1 TSV-3D互连及大马士革铜互连技术
2.2 大马士革钴互连技术
2.3 铜互连材料的热处理技术
3 高密度凸点电镀成形及界面可靠性
3.1 微凸点电镀成形问题
3.2 微凸点高性能阻挡层技术
3.3 微凸点的界面可靠性
3.3.1 IMCs侧壁生长
3.3.2 多孔IMC
3.3.3 微凸点锡须的生长
4 镀层特殊结构制备与调控技术
4.1 大单晶互连材料
4.2 多层合金薄膜
4.3 微纳米针锥
4.4 纳米孪晶铜
5 基于微纳针锥结构镀层的高密度凸点低温固态键合技术
6 水相电化学及化学接枝有机绝缘膜技术
6.1 电接枝
6.2 化学接枝
6.3 低介电常数薄膜
7 总结与展望
©软件著作权归作者所有。本站所有文件均来源于网络,仅供学习使用,请支持正版!
转载请注明出处!
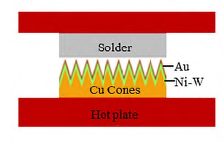







发表评论 取消回复