芯片制造中的化学镀技术研究进展
叶淳懿,邬学贤,张志彬,丁萍,骆静利,符显珠 (深圳大学材料学院)
摘要:芯片制造中大量使用物理气相沉积、化学气相沉积、电镀、热压键合等技术来实现芯片导电互连. 与这些技术相比, 化学镀因具有均镀保形能力强、工艺条件温和、设备成本低、操作简单等优点, 被人们期望应用于芯片制造中, 从而在近年来得到大量的研究. 本综述首先简介了芯片制造中导电互连包括芯片内互连、芯片3D 封装硅通孔(TSV)、重布线层、凸点、键合、封装载板孔金属化等制程中传统制造技术与化学镀技术的对比, 说明了化学镀用于芯片制造中的优势; 然后总结了芯片化学镀的原理与种类、接枝与活化前处理方法和关键材料; 并详细介绍了芯片内互连和TSV互连化学镀阻挡层、种子层、互连孔填充、化学镀凸点、再布线层、封装载板孔互连种子层以及凸点间键合的研究进展; 且讨论了化学镀液组成及作用, 超级化学镀填孔添加剂及机理等. 最后对化学镀技术未来应用于新一代芯片制造中进行了展望.
关键词:芯片导电互连;3D封装硅通孔;阻挡层;种子层;凸点;键合
目录介绍
1 引言
2 芯片化学镀原理与制程
2.1 芯片化学镀原理及常用镀种
2.2 芯片化学镀前接枝与接枝剂
2.3 芯片化学镀前活化及活化剂
3 芯片导电互连制程
3.1 芯片内互连制程
3.2 三维封装TSV制程
3.3 RDL、凸点及键合
4 芯片互连化学镀阻挡层
4.1 芯片阻挡层作用及材料
4.2 化学镀镍基阻挡层
4.3 化学镀钴基阻挡层
5 芯片互连化学镀铜种子层
5.1 芯片化学镀铜镀液组成及作用
5.2 化学镀芯片内铜种子层
5.3 化学镀TSV铜种子层
5.4 芯片封装载板化学镀种子层
6 芯片互连化学镀孔填充
6.1 超填孔互连化学镀添加剂及机理
6.2 芯片内互连化学镀填孔
6.3 RDL和凸点键合化学镀填孔
7 总结与展望
©软件著作权归作者所有。本站所有文件均来源于网络,仅供学习使用,请支持正版!
转载请注明出处!
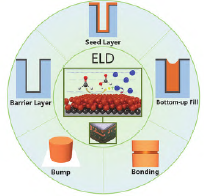







发表评论 取消回复