HBM制造技术演进与今后的发展趋势
付永朝,陈之文,王静(宏茂微电子(上海)有限公司)
摘要:随着智能数据应用的飞速发展,内存带宽限制导致的算力瓶颈日益明显。面对市场对高性能计算和数据处理能力不断攀升的需求,解决这一瓶颈问题正变得越来越具有挑战性。在这一背景下,高带宽内存(High Bandwidth Memory,HBM)被视为突破算力瓶颈的关键方案之一,并且已经成为当前先进封装技术领域的研发热点。本文将回顾HBM 制造工艺的发展历程,分析其技术优势,并对其未来的发展方向进行展望。
关键词:高带宽内存;硅通孔;晶圆键合;Via-last;凸点;无凸点
目录介绍
0 引言
1 HBM的结构
2 HBM的制造工艺
2.1 晶圆制程
2.2 三维堆叠制程(3D-Stacking)
3 HBM 制造技术的未来展望
3.1 Bumpless键合技术的必要性
3.2 Bumpless键合技术的类型
4 结论
©软件著作权归作者所有。本站所有文件均来源于网络,仅供学习使用,请支持正版!
转载请注明出处!
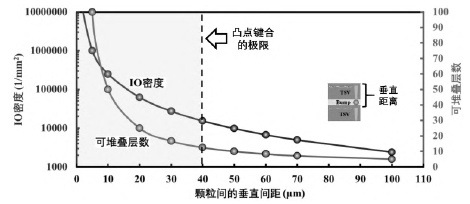







发表评论 取消回复