三维集成电路先进封装中聚合物基材料的研究进展
范泽域1,2,王方成1,2,刘强1,2,黄明起3,叶振文3,张国平1,2,孙蓉1, 2(1.中国科学院深圳先进技术研究院;2. 深圳先进电子材料国际创新研究院;3.深圳市化讯半导体材料有限公司)
摘要:人工智能、大数据、物联网和可穿戴设备的迅猛发展,极大地催生了对高端芯片的需求。随着摩尔定律发展趋缓,尺寸微缩技术使芯片遭遇了物理节点失效、经济学定律失效,以及性能、功耗、面积指标不足等诸多问题。作为延续和拓展摩尔定律的重要赛道,三维先进封装技术已成为推动高端芯片向多功能化以及产品多元化集聚发展的重要动力。先进封装技术的迅猛发展对聚合物基关键封装材料的耐腐蚀性、电气、化学和机械性能都提出了更高的要求。针对三维集成电路的先进封装工艺需求,论述了不同聚合物基关键材料的研究进展及应用现状,明晰了不同聚合物基材料所面临的挑战和机遇,提出了相应的解决方案,并展望了未来的研究方向。
关键词:先进封装;三维封装;聚合物;临时键合
目录介绍
0 引言
1 聚合物基直接材料在三维封装中的应用
1.1 聚酰亚胺
1.1.1 热固性聚酰亚胺
1.1.2 热塑性聚酰亚胺
1.1.3 聚酰亚胺分子结构设计
1.2 再布线层
1.3 底部填充材料
2 聚合物基临时材料在三维封装中的应用
2.1 光刻胶
2.1.1 光刻胶概述
2.1.2 光刻胶面临的挑战与发展现状
2.2 临时键合材料
2.2.1 临时键合的要求
2.2.2 临时键合材料及解键合工艺
3 结束语
©软件著作权归作者所有。本站所有文件均来源于网络,仅供学习使用,请支持正版!
转载请注明出处!
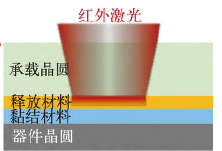







发表评论 取消回复