无凸点混合键合三维集成技术研究进展
戚晓芸,马岩,杜玉,王晨曦(哈尔滨工业大学材料结构精密焊接与连接全国重点实验室)
摘要:数字经济时代,高密度、低延迟、多功能的芯片是推动人工智能、大模型训练、物联网等高算力需求与应用落地的基石。引线键合以及钎料凸点的倒装焊存在大寄生电容、高功耗、大尺寸等问题,使传统封装难以满足窄节距、低功耗、小尺寸的应用场景。无凸点混合键合技术能够实现极窄节距的互连,在有效避免倒装焊凸点之间桥连短路的同时降低了寄生电容,减小了封装尺寸和功耗,满足了高性能计算对高带宽、多功能的要求。对无凸点混合键合技术所采用的材料、键合工艺与方法以及当前在三维集成中的应用展开介绍,并对其发展趋势进行了展望。
关键词:混合键合;高密度互连;三维集成;先进封装
目录介绍
0 引言
1 应用于无凸点混合键合结构的材料
1.1 Cu/无机介质混合键合
1.2 Cu/有机介质混合键合
1.3 纳米孪晶Cu/介质混合键合
1.4 非Cu金属参与的混合键合
2 无凸点混合键合工艺方法
2.1 超高真空表面活化键合
2.2 化学清洗辅助键合
2.3 等离子体活化键合
2.4 多步协同活化键合
2.5 金属钝化层辅助键合
3 面向高密度互连的混合键合应用
3.1 应用于CMOS芯片集成
3.2 应用于高带宽存储芯片制造
3.3 应用于系统集成
4 结束语
©软件著作权归作者所有。本站所有文件均来源于网络,仅供学习使用,请支持正版!
转载请注明出处!
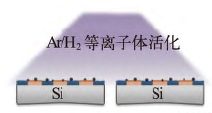







发表评论 取消回复