人工智能芯片先进封装技术
田文超1,谢昊伦2,陈源明3,赵静榕3,张国光4 (1.西安电子科技大学机电工程学院;2.西安电子科技大学杭州研究院;3.上海轩田工业设备有限公司;4.佛山市蓝箭电子股份有限公司)
摘要:随着人工智能(AI)和集成电路的飞速发展,人工智能芯片逐渐成为全球科技竞争的焦点。在后摩尔时代,AI芯片的算力提升和功耗降低越来越依靠具有硅通孔、微凸点、异构集成、Chiplet等技术特点的先进封装技术。从AI芯片的分类与特点出发,对国内外典型先进封装技术进行分类与总结,在此基础上,对先进封装结构可靠性以及封装散热等方面面临的挑战进行总结并提出相应解决措施。面向AI应用,对先进封装技术的未来发展进行展望。
关键词:人工智能芯片;先进封装;可靠性;封装散热
目录介绍
0 引言
1 AI芯片
1.1 AI芯片分类
1.2 AI芯片发展现状
2 先进封装技术
2.1 FO封装
2.1.1 台积电InFO
2.1.2 日月光FOCoS
2.1.3 华天科技eSiFO
2.1.4 长电科技XDFOI
2.2 2.5D封装
2.2.1 英特尔EMIB
2.2.2 台积电CoWoS
2.2.3 三星I-Cube
2.3 3D集成技术
2.3.1 台积电SoIC
2.3.2 英特尔Foveros
2.3.3 三星X-Cube
2.4 Chiplet技术兴起
3 先进封装面临的挑战
3.1 晶圆翘曲
3.2 焊点可靠性
3.3 TSV可靠性
3.4 RDL可靠性
3.5 封装散热
4 展望
5 结束语
©软件著作权归作者所有。本站所有文件均来源于网络,仅供学习使用,请支持正版!
转载请注明出处!
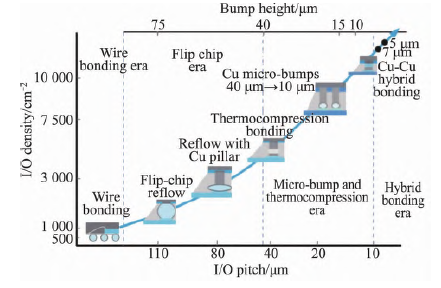







发表评论 取消回复