电子封装铜互连线多场耦合可靠性及损伤机制的研究进展
曾超凡,朱忆雪,杨兆凯,包宏伟,马飞( 西安交通大学金属材料强度国家重点实验室)
摘要: 伴随着集成电路集成度的增加,芯片尺寸不断减小,铜互连线的尺寸也逐渐达到纳米级别,铜互连线在力、热、电多场耦合条件下的电迁移行为是影响小尺寸下其可靠性的重要因素。首先介绍了小尺寸铜互连面临的主要问题,如,电子散射及扩散阻挡层导致的电阻率的增加以及电迁移现象的加剧。其次,探讨了微观结构、宏观尺寸以及制作工艺等方面对铜互连线电迁移行为的影响,这些影响因素显著改变了铜互连线的电迁移行为及寿命; 介绍了对铜互连线进行电迁移行为及寿命预测的有限元法、相场法、熵损伤模型等模拟方法。最后,根据目前已知的影响电迁移的因素进一步指出了有望改善铜互连线的电迁移的发展策略以及研究方向,为高性能铜互连材料设计提供重要参考。
关键词: 集成电路; 铜互连线; 电迁移; 扩散阻挡层; 模拟方法
目录介绍
1 前言
2 小尺寸铜互连的电阻率
2. 1 电子散射效应
2. 2 扩散阻挡层效应
3 铜互连中的原子迁移
3. 1 电迁移、热迁移和应力迁移
3. 2 电迁移的影响因素
3. 2. 1 微观结构的影响
3. 2. 2 互连线尺寸的影响
3. 2. 3 其他影响因素
3. 3 电迁移模型及多场耦合下的模拟方法
3. 3. 1 电迁移模型
3. 3. 2 多场耦合条件下电迁移的模拟方法
4 结语
©软件著作权归作者所有。本站所有文件均来源于网络,仅供学习使用,请支持正版!
转载请注明出处!
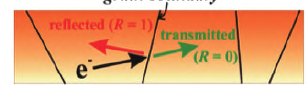







发表评论 取消回复