导热环氧树脂基底部填充材料的研究进展
【摘 要】底部填充胶(Underfill)作为一种重要的集成电路封装电子胶粘剂,在先进封装如2.5D、3D封装 中,用于缓解芯片封装中不同材料之间热膨胀系数不匹配带来的应力集中问题,进而提高器件封装可靠性。 在各种底部填充材料中,环氧树脂基底部填充胶是最常用的,也是商业化最成熟的产品。然而,广泛使用的毛 细管环氧基底部填充胶材料的导热系数较低,无法满足功率密度更高的下一代先进封装芯片不断增长的散热 要求。
【关键词】底部填充胶;环氧树脂;导热性
目录介绍
0 前 言
1 底部填充胶材料的性能需求
2 导热性能
2.1 填料提升导热性能
2.2 界面调节提升导热性能
2.3 提高填料的分散性
2.4 构建混合填料网络结构
2.5 降低接触热阻
3 展 望
©软件著作权归作者所有。本站所有文件均来源于网络,仅供学习使用,请支持正版!
转载请注明出处!
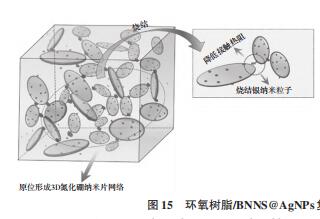







发表评论 取消回复