先进封装中铜-铜低温键合技术研究进展
王帅奇,邹贵生,刘磊 (清华大学)
摘要: Cu-Cu低温键合技术是先进封装的核心技术,相较于目前主流应用的Sn 基软钎焊工艺,其互连节距更窄、导电导热能力更强、可靠性更优。文中对应用于先进封装领域的Cu-Cu低温键合技术进行了综述,首先从工艺流程、连接机理、性能表征等方面较系统地总结了热压工艺、混合键合工艺实现Cu-Cu低温键合的研究进展与存在问题,进一步地阐述了新型纳米材料烧结工艺在实现低温连接、降低工艺要求方面的优越性,概述了纳米线、纳米多孔骨架、纳米颗粒初步实现可图形化的Cu-Cu低温键合基本原理。结果表明,基于纳米材料烧结连接的基本原理,继续开发出宽工艺冗余、窄节距图形化、优良互连性能的Cu-Cu低温键合技术是未来先进封装的重要发展方向之一。创新点: (1) 系统地总结了热压工艺、混合键合工艺实现Cu-Cu低温键合的研究进展。(2) 阐述了新型纳米材料烧结连接的基本原理、典型方法及工艺优势。
关键词: 先进封装;混合键合;Cu-Cu键合;窄节距;烧结
目录介绍
0 序言
1 热压键合工艺
1.1 提高Cu 原子扩散速率
1.2 防止/减少待键合表面氧化
2 混合键合工艺
2.1 Cu/SiO2介质的混合键合
2.1.1 基于表面激活的混合键合
2.1.2 基于DBI的混合键合
2.1.3 基于SAB的混合键合
2.2 Cu/粘结剂介质的混合键合
3 热压键合和混合键合的工艺难点
3.1 工艺要求非常苛刻
3.2 难以灵活适用于2.5D互连
4 Cu纳米材料烧结连接
4.1 纳米材料烧结连接的基本原理
4.2 Cu纳米线烧结
4.3 Cu纳米多孔骨架烧结
4.4 Cu纳米颗粒烧结
5 结论
©软件著作权归作者所有。本站所有文件均来源于网络,仅供学习使用,请支持正版!
转载请注明出处!
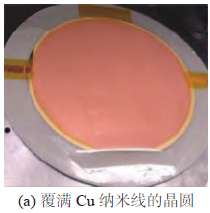







发表评论 取消回复