电子封装低温焊料研究进展
李方樑1,甘贵生1,窦俊丰1,谢道春1,朱俊雄1,耿明利1,韩军2,杨栋华1,潘浩1,夏大权3,徐向涛3(1 重庆理工大学 重庆特种焊接材料与技术高校工程技术研究中心;2 西安诺博尔稀贵金属材料股份有限公司;3 重庆平伟实业股份有限公司)
摘要:多温度梯度的互连焊料组合是实现芯片高密度集成的关键,低温焊料合金是实现低温工艺的前提和电子产品高可靠性的保障。本文综述了Sn-58Bi 低温焊料、In 基(In-Sn、In-Pb、In-Ag、In-Bi)低温焊料以及其他低温焊料(多元合金、高熵合金、Ga 基合金)的研究进展,指出含Bi 的Sn-Bi 焊料无法回避Bi 的偏析和脆断,最优选择是焊接过程中利用混合焊料中其他焊料成分或者外加颗粒与Bi 反应形成含Bi 化合物消耗掉Bi,不丧失Sn-Bi 焊料的焊接性的同时与现有的回流工艺相匹配;In 基二元或多元低温焊料以及SnBiInX 高熵合金,焊接后脆性Bi 相和低熔点Bi-In、Sn-In 化合物形成不可避免,应摒弃Bi 的使用并控制Sn 的含量,如采用低熔点Ga 或In 与高熔点Cu 混合形成非冶金结合的混合或复合焊料,低温瞬态液相键合实现低熔点成分熔化温度附近的低温互连,低熔点相消耗殆尽和高熔点化合物的形成是保证焊点高强度和高温服役的前提。
关键词:互连焊料组合;低温焊料;高密度集成;先进封装
目录介绍
关键词:互连焊料组合;低温焊料;高密度集成;先进封装
1 电子封装低温焊料研究进展
1.1 Sn-Bi低温焊料研究进展
1.2 In 基低温焊料研究进展
1.2.1 In-Sn体系
1.2.2 In-Pb体系
1.2.3 In-Ag体系
1.2.4 In-Bi体系
1.3 其他低温焊料研究进展
1.3.1 多元合金
1.3.2 高熵合金
1.3.3 Ga基合金
1.4 低温焊料的主要性能
2 总结与展望
©软件著作权归作者所有。本站所有文件均来源于网络,仅供学习使用,请支持正版!
转载请注明出处!
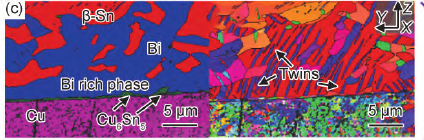







发表评论 取消回复