集成电路芯片锡基微凸点电迁移:从物理本质到可靠性提升
黄明亮,王胜博,尤海潮,刘厚麟,任婧,黄斐斐(大连理工大学材料科学与工程学院 电子封装材料实验室)
摘要:随着先进封装技术向微型化、高性能方向发展,集成电路芯片锡基微凸点的直径持续减小至微米尺度,通过单个凸点的电流密度随直径减小呈平方增加,其电迁移行为与机理研究对集成电路芯片互连可靠性评估与设计具有重要价值。本文归纳分析了芯片互连微凸点(焊点)电迁移现象的物理本质、主要影响因素和研究方法;系统综述了微焊点固-固电迁移过程中的极性效应、反极性效应和两相分离等电迁移行为特征与液-固电迁移过程中原子迁移、相析出和相溶解等电迁移行为特征;梳理评价了电迁移寿命的评估模型及修正模型;最后阐明了微焊点电迁移可靠性提升的方法,并展望了集成电路芯片互连锡基微凸点电迁移未来的研究方向和可靠性分析方法。
关键词:电子封装,芯片互连,锡基微凸点,电迁移,可靠性
目录介绍
1 电迁移研究概述
1.1 电迁移的物理本质和主要影响因素
1.1.1 电迁移的物理本质
1.1.2 电迁移可靠性的主要影响因素
(1) 电流密度
(2) 焊点温度
(3) β-Sn晶粒的各向异性
(4) 多物理场耦合作用
1.2 电迁移研究方法
1.2.1 电迁移测试标准
1.2.2 电迁移测试焊点结构
2 微凸点电迁移行为特征及寿命评估模型
2.1 微凸点固-固电迁移行为特征
2.1.1 极性效应
2.1.2 反极性效应
2.1.3 两相分离
2.2 微凸点液-固电迁移行为特征
2.3 电迁移寿命评估模型
2.3.1 Black方程
2.3.2 Black方程的修正
2.3.3 数值模拟在电迁移寿命评估中的应用
3 微凸点电迁移可靠性提升方法
3.1 微凸点合金成分优化
3.1.2 合金化方式提升Sn-Bi基钎料合金体系微凸点电迁移可靠性
3.2 添加增强相方式提升微凸点钎料合金电迁移可靠性
3.3 UBM选择与组合
3.4 微凸点中β-Sn晶粒晶体取向调控
3.5 微型化趋势下全金属间化合物焊点设计与制备
4 总结与展望
©软件著作权归作者所有。本站所有文件均来源于网络,仅供学习使用,请支持正版!
转载请注明出处!
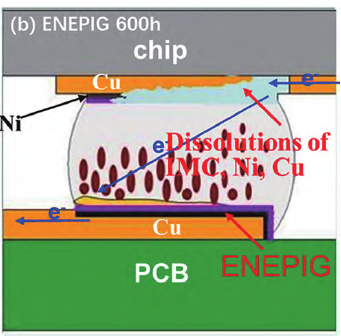





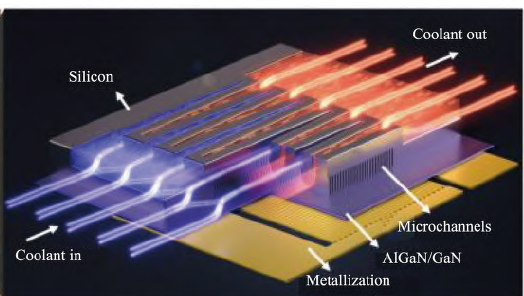

发表评论 取消回复