热壁CVD制备工艺对8英寸SiC外延层厚度均匀性的影响
鹿润林1,郑丽丽1,张辉2,王人松3,胡动力3(1.清华大学航天航空学院;2.清华大学公共安全研究院;3.连科半导体有限公司)
摘要:本文针对典型8英寸热壁卧式SiC外延生长系统建立了考虑衬底转动、Si-C-Cl-H体系反应机理和多物理过程热质输运的数学模型,并用于三维数值仿真模拟研究。此外,本文特别研究了不同衬底表面平均温度、进气流量、进气Si/H2比对外延层生长速率和厚度均匀性的影响。结果表明:衬底转动提高了衬底表面温度分布均匀性,SiC瞬时生长速率主要受表面附近生长组分浓度影响;外延层厚度均匀性主要受SiC瞬时生长速率沿流动方向的分布影响,衬底前缘和后缘的瞬时生长速率须相互补偿以提高厚度均匀性;提高衬底表面平均温度、降低进气流量和降低进气Si/H2比均导致瞬时生长速率沿流动方向的分布由上凸向下凸转变,衬底表面实际生长速率的分布从边缘低中间高逐渐过渡为边缘高中间低;所考察的参数范围内进气流量对瞬时生长速率分布影响最大。
关键词:碳化硅;外延生长;化学气相沉积;热-质输运;数学模型
目录介绍
0 引言
1 物理与数学模型
1.1 热壁卧式SiC 外延生长系统
1.2 控制方程和边界条件
1.2.1 在固体件中能量输运
1.2.2 气体输运
1.2.3 晶体生长界面条件
1.2.4 化学反应
1.2.5 外边界条件
1.3 模型求解
2 结果与讨论
2.1 基准算例
2.1.1 衬底转动对温度分布的影响
2.1.2 组分浓度分布
2.1.3 SiC瞬时生长速率分布
2.1.4 SiC实际生长速率分布及非均匀性
2.2 参数化研究
2.2.1 衬底表面平均温度
2.2.2 进气流量
2.2.3 进气Si/H2比
3 结论
©软件著作权归作者所有。本站所有文件均来源于网络,仅供学习使用,请支持正版!
转载请注明出处!
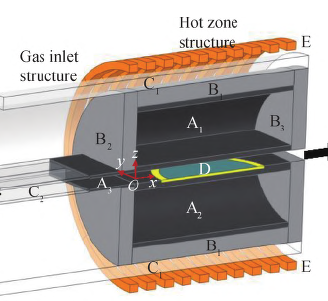







发表评论 取消回复