电子封装用铜及银键合丝研究进展
梁爽1,黄福祥1,彭成1,钟明君1,吴保安2,唐会毅2 (1.重庆理工大学材料科学与工程学院;2.重庆材料研究院有限公司)
摘要:随着电子封装高密度化、高速度化和小型化发展,金键合丝由于成本和性能等问题已不能满足要求。成本更加低廉的铜及银键合丝逐渐成为金丝替代品,但铜键合丝存在硬度高、易氧化、工艺复杂等问题,银键合丝存在抗拉强度低、Ag+迁移和高温抗氧化抗性差等缺点。针对上述问题,广大学者进行了分析和研究,根据相关的文献、专利和产品,综述了铜及银键合丝的性能特点、成分设计、制备工艺、可靠性研究和性能改善方法,并对其发展前景进行了展望。
关键词:电子封装;铜键合丝;银键合丝;成分设计
目录介绍
0 引言
1 铜键合丝
1.1 键合工艺优化
1.2 铜合金键合丝
1.3 镀层铜键合丝
1.4 铜键合丝可靠性研究
2 银键合丝
2.1 银合金键合丝
2.2 镀层银键合丝
2.3键合银丝可靠性研究
3 结语
©软件著作权归作者所有。本站所有文件均来源于网络,仅供学习使用,请支持正版!
转载请注明出处!
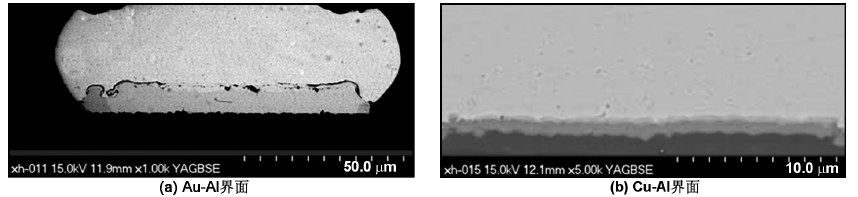







发表评论 取消回复