基于TSV倒装焊与芯片叠层的高密度组装及封装技术
汤姝莉,赵国良,薛亚慧,袁海,杨宇军 (西安微电子技术研究所)
摘要:系统级封装(SiP)及微系统技术能够在有限空间内实现更高密度、更多功能集成,是满足宇航、武器装备等高端领域电子器件小型化、高性能、高可靠需求的关键技术。重点阐述了基于硅通孔(TSV)转接板的倒装焊立体组装及其过程质量控制、基于键合工艺的芯片叠层、基于倒装焊的双通道散热封装等高密度模块涉及的组装及封装技术,同时对利用TSV 转接板实现多芯片倒装焊的模组化、一体化集成方案进行了研究。基于以上技术实现了信息处理SiP模块的高密度、气密性封装,以及满足多倒装芯片散热与CMOS图像传感器(CIS)采光需求的双面三腔体微系统模块封装。
关键词:硅通孔;倒装芯片;芯片叠层;高效散热;高密度组装
目录介绍
1 引言
2 高密度集成关键技术
2.1 基于TSV 转接板的倒装焊立体组装技术
2.2 基于键合工艺的芯片叠层技术
3 基于倒装焊的高效散热封装技术
4 高密度组装及封装技术的典型应用
5 结论
©软件著作权归作者所有。本站所有文件均来源于网络,仅供学习使用,请支持正版!
转载请注明出处!
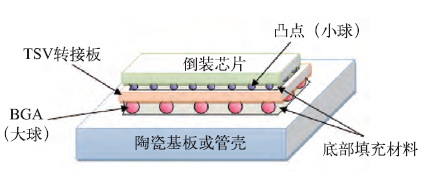







发表评论 取消回复