LTCC封装技术研究现状与发展趋势
李建辉,丁小聪 (中国电子科技集团公司第四十三研究所微系统安徽省重点实验室)
摘要:低温共烧陶瓷(Low Temperature Co-Fired Ceramics, LTCC)封装能将不同种类的芯片等元器件组装集成于同一封装体内以实现系统的某些功能,是实现系统小型化、集成化、多功能化和高可靠性的重要手段。总结了LTCC基板所采用的封装方式,阐述了LTCC基板的金属外壳封装、针栅阵列(Pin Grid Array, PGA)封装、焊球阵列(Ball Grid Array, BGA)封装、穿墙无引脚封装、四面引脚扁平(Quad Flat Package, QFP) 封装、无引脚片式载体(Leadless Chip Carrier, LCC)封装和三维多芯片模块(Three-Dimensional Multichip Module, 3D-MCM)封装技术的特点及研究现状。分析了LTCC基板不同类型封装中影响封装气密性和可靠性的一些关键技术因素,并对LTCC封装技术的发展趋势进行了展望。
关键词:LTCC;陶瓷封装;一体化封装;三维多芯片模块;系统级封装
目录介绍
1 引言
2 LTCC封装材料特性
2.1 LTCC 基板材料
2.2 LTCC 封装金属材料
2.3 LTCC 封装焊接材料
3 LTCC封装技术研究现状
3.1 LTCC 金属外壳封装
3.2 LTCC 针栅阵列封装
3.3 LTCC 焊球阵列封装
3.4 LTCC 穿墙无引脚封装
3.5 LTCC QFP 封装
3.6 LTCC LCC 封装
3.7 LTCC 3D-MCM 封装
4 LTCC封装技术发展趋势
4.1 高热膨胀系数LTCC 封装
4.2 高导热LTCC 封装
4.3 低成本LTCC 封装
4.4 系统级LTCC 封装
5 结论
©软件著作权归作者所有。本站所有文件均来源于网络,仅供学习使用,请支持正版!
转载请注明出处!
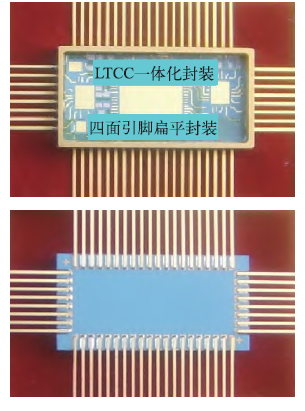







发表评论 取消回复