车规级芯片封装界面可靠性研究进展
盛方辉1,梁澎坚2,马宝光2,杨晶磊3,戴恩期4,李兴森1 (1.广东工业大学;2.广州市香港科大霍英东研究院;3.香港科技大学;4.广州国机润滑科技有限公司)
摘要: 控制芯片作为汽车电子控制单元(ECUs)的核心部件,其封装可靠性直接影响整车安全性能。针对微控制单元(MCU)与系统级芯片(SoC)两类主流架构,基于汽车典型工况下的机械振动与温度冲击复合载荷特征,系统研究了封装界面分层失效机制。研究表明:在多载荷耦合作用下,贴片界面、引线键合界面及底部填充胶界面等关键部位的性能退化导致的界面粘接强度衰减与材料热失配效应是诱发分层失效的主导因素。通过对比虚拟裂纹闭合技术(VCCT)、J积分法及内聚力模型(CZM)的数值模拟适用性,表明CZM 在非线性材料大变形条件下具有界面失效表征优势,J积分则适用于非线性材料小变形断裂领域,而VCCT在线弹性稳态裂纹扩展分析中更具计算效率优势。
关键词:界面分层;有限元分析;车规级芯片;可靠性;可拓学
目录介绍
1 前言
2 车规级计算芯片封装概述
2.1 车规级计算芯片封装技术概览
2.2 车规级芯片工作环境
3 芯片可靠性问题及其影响机制
3.1 贴片界面可靠性
3.2 底部填充胶界面可靠性
3.3 引线键合
3.4 钝化层可靠性
4 有限元分析技术在芯片封装界面分层失效中的应用
5 结束语
©软件著作权归作者所有。本站所有文件均来源于网络,仅供学习使用,请支持正版!
转载请注明出处!
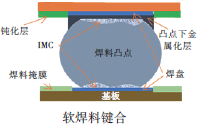







发表评论 取消回复