先进封装加速迭代,迈向2.5D-3D封装
平安证券
摘要:在以人工智能、高性能计算为代表的新需求驱动下,先进封装应运而生,发展趋势是小型化、高集成度,历经直插型封装、表面贴装、面积阵列封装、2.5D/3D封装和异构集成四个发展阶段。先进封装开辟了More-than-Moore的集成电路发展路线,能够在不缩小制程节点的背景下,仅通过改进封装方式就能提升芯片性能,还能够打破“存储墙”和“面积墙”。发展趋势由单芯片封装向多芯片封装发展,聚焦关键工艺。AI和高性能计算芯片的关键瓶颈在于CoWoS产能。先进封装景气度高于整体封装行业,未来向2.5D/3D进发。
关键词:先进封装;后摩尔时代;高算力;单芯片;多芯片;系统级
目录介绍
1 封装荒野现状与发展趋势
1.1 先进封装属于中道工艺,涉及部分前道工艺与设备
1.2 后摩尔时代,先进封装打破“存储墙”与“面积墙”
1.3 封装技术持续迭代,发展趋势是小型化、高度集成
2 典型封装技术
2.1 单芯片封装
2.1.1 倒片封装(FLIP-CHIP):芯片倒置,利用凸块连接
2.1.2 扇入型/扇出型封装(FAN-IN/FAN-OUT):在晶圆上进行整体封装,成本更低
2.2 多芯片封装
2.2.1 1.5D/3D封装:多层芯片堆叠,AI驱动下HBM需求大增,COWOS产能成为算力关键卡口
2.2.2 系统级封装(SIP):多个子芯片集成,良率更高
2.2.3 芯粒(CHIPLET):多颗小芯粒灵活组装,支持异构集成
3 先进封装市场
3.1 市场规模:受下游旺盛需求拉动,先进封装增速高于传统封装
3.2 竞争格局:海外IDM和FOUNDRY掌握先机封装前沿技术
4 相关标的
4.1 润欣科技:增资奇异摩尔,专注CHIPLET解决方案
4.2 通富微电:封测行业全球第四,提供国内最完善的CHIPLET封装解决方案
4.3 甬矽电子:BUMPING通线量产,打造“BUMPING+CP+FC+FT”一站式封测平台
4.4 其他先进封装相关公司
5 风险提示
©软件著作权归作者所有。本站所有文件均来源于网络,仅供学习使用,请支持正版!
转载请注明出处!
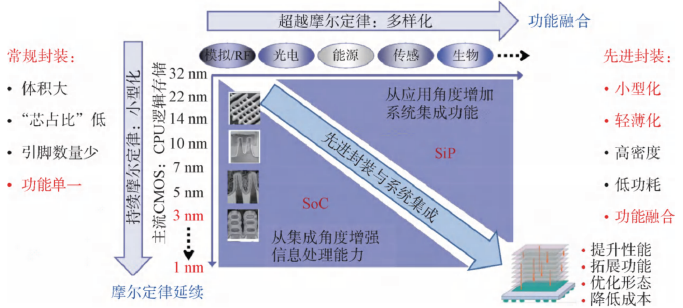







发表评论 取消回复