高端先进封装:AI时代关键基座,重视自主可控趋势下的投资机会
来源:开源证券 分析师:陈蓉芳,陈瑜熙
摘要:先进封装是“超越摩尔”思路下提升芯片性能的重要路径。封装工艺已实现由“封”向“构”升级,发展出如FC、FO、WLCSP、SiP和2.5D/3D等先进封装,优势明显(性能高、成本低、面积小、周期短等),应用边际不断拓宽。在高性能计算、AI/机器学习、数据中心、ADAS、高端消费电子设备等终端的强势需求下,Yole预测全球先进封装市场规模将从2023年的378亿元增加至2029年的695亿美元。电信与基础设施(包括AI/HPC)是主要驱动力。大陆厂商具备先进封装产业化能力。封测是中国大陆在半导体产业的强势环节,头部厂商在中高端先进封装市场已占据一定份额,有望率先从追赶走向引领。重视本土厂商高端封测产线产能、良率和产能利用率提升带来的投资机会。
关键词:先进封装;应用;产能;后摩尔时代;需求侧;供给侧;2.5D/3D
目录介绍
1、后摩尔时代:AI应用打开高端先进封装成长空间
1.1、 先进封装:扩展“超越摩尔”的思路,优势充分、应用场景丰富
1.1.1、 先进封装是“超越摩尔”思路下提升芯片性能的重要径
1.1.2、 先进封装优势明显,应用场景丰富
1.2、 复盘CoWoS封装发展史:AI算力革命的封装基石
1.2.1、 阶段一:探索与验证
1.2.2、 阶段二:AI/HPC开启CoWoS规模化落地
1.2.3、 阶段三:技术平台化+工艺择优
2、 需求侧:HPC/汽车电子带动先进封装市场扩张
2.1、 HPC/汽车电子带动先进封装市场扩张
2.2、 算力产业军备竞赛,高端先进封装需求具有持续性
3、 供给侧:先进封装玩家众多,国产厂商加速突破
3.1、 FC、2.5D/3D和SiP市场空间份额高,2.5D/3D晶圆数增长快
3.2、 全球领先厂商:大技术平台+先进工艺,竞争高端市场空间
3.3、 大陆厂商:具备先进封装产业化能力
4、 格局生变:关注本土高端先进封装切入机会
4.1、 CoWoS走向分工合作,OSAT 迎来切入窗口
4.2、 高端先进封装:国产AI算力产业链瓶颈与破局之路
5、 风险提示
©软件著作权归作者所有。本站所有文件均来源于网络,仅供学习使用,请支持正版!
转载请注明出处!
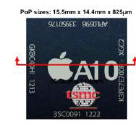







发表评论 取消回复